
Strain Mapping
Measure engineered strain distributions in modern semiconductor devices via PED-enhanced NBD
PATENT PENDINGEnhanced nanobeam diffraction resolves strain at the nanometer scale
Acquisition of Virtual STEM reference image
Ultra-fast nanobeam precession electron diffraction scanned acquisition
Automated local strain analysis via proprietary algorithm
Optimized analysis for FinFET devices
Spatial resolution < 2 nm attainable (FEG TEM)
Strain sensitivity < 2 x 10-4 (FEG TEM)
Intuitive workflow
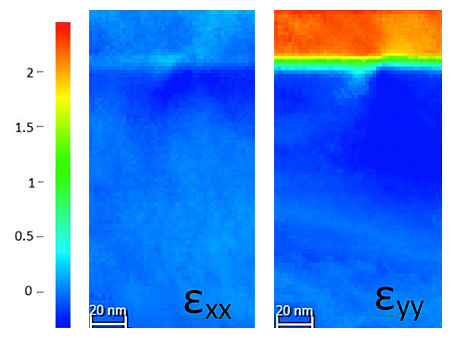 Strain Imaging of a SiGe (62/38 at.%) blanket film, showing a dislocation
at the Si-SiGe interface
Strain Imaging of a SiGe (62/38 at.%) blanket film, showing a dislocation
at the Si-SiGe interface
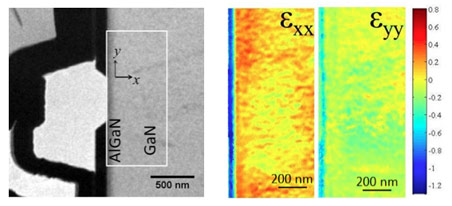 Strain Imaging in GaN HEMT device Download PDF for source details
Strain Imaging in GaN HEMT device Download PDF for source details